Characterization of Surface Metallic Contamination
Home » Characterization of Surface Metallic Contamination
In order to control contaminants, it is necessary to identify and quantify them.
Utilizing both TXRF and SurfaceSIMS.XP provides the total solution with the best
value for surface contamination measurements on semiconductor surfaces.
Ultra-clean surfaces are critically important to the successful processing of semiconductor devices. Likewise, eliminating or reducing Al and other metal surface contamination on silicon wafers is a very critical part of IC processes. To control contaminants, it is necessary to identify and quantify them. Choosing an appropriate measurement technique is important for providing accurate and consistent results. Utilizing both TXRF and SurfaceSIMS.XP (XP = extended profile) provides the total solution with the best detection limits and value for surface contamination measurements.
The present application note highlights some important advantages of using SurfaceSIMS.XP (XP = extended profile) and TXRF to determine surface Al contamination on processed Si wafers.
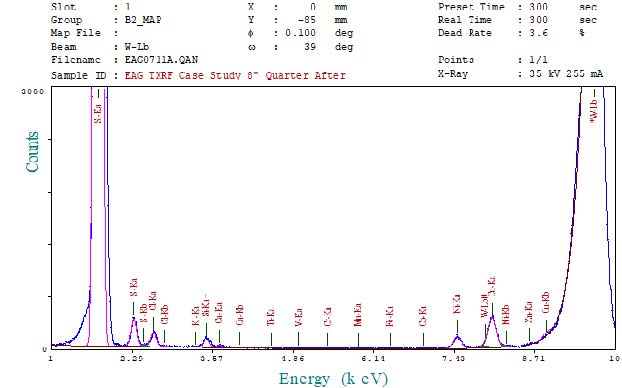
Would you like to learn more about Surface Metallic Contamination?
Contact us today for your surface metallic contamination needs. Please complete the form below to have an EAG expert contact you.