
Extractable & Leachable Studies for Consumer Products Webinar
In this webinar we introduce Extractable and Leachable tests which identify chemical components that can migrate out of a product.
Home » AVS 71 International Symposium and Exhibition

We are excited to announce that Eurofins EAG Laboratories will be speaking at the AVS 71 Symposium in Charlotte, NC, September 21-26.
Meet Dr. Yimeng Chen on September 22nd as he presents Direct Observation of Mg Diffusion Through Screw-type Dislocations in a GaN Device Using Atom Probe Tomography.
Session: NS1-MoM: Frontier in Nanoscale Electron, Ion, and Scanning Probe Imaging
Session Time: Monday, September 22, 2025 8:15 AM – 10:30 AM
Presentation Time: 9:00 AM – 9:15 AM
Location: 206 A W
Abstract
Large band gap vertical GaN power devices have been developed for high efficiency switch devices in high-power applications [1]. These devices incorporate p-type GaN through Mg doping in selective regions. Precise control of dopant concentration is crucial for the electronic properties of semiconductor devices. However, interfacial diffusion or through defect migration of dopants during fabrication process or operation can degrade the performance. Dopant segregation at threading dislocations can induce current leakage and Mg diffusion during high temperature annealing was reported [2].
We analyzed a GaN device removed from a USB charger, purchased from the market, that contained the NV6125 microchip for power switching control. The microchip was mechanically de-processed at EAG down to the field-effect-transistor level , exposing the source/drain region for microstructural characterization. A ~0.5 um thick cross-section was made along the gate via Focused Ion Beam (FIB) and observed using Scanning Transmission Electron Microscopy (STEM). STEM observation confirmed a layered structure composed of dielectric oxide, metal contact, and p-type GaN and AlGaN layers on GaN. The GaN epi exhibits a high threading dislocation density (TDD) that we estimate to be ~1e9/cm^2. Using a simple 2-beam tilting strategy in STEM we were quickly able to identify each dislocation as either edge, screw, or mixed type.
Precise STEM carbon-deposition was utilized to mark and target defect free regions as well as individual dislocations. Small pillars ~0.5umx0.5umx4ums containing the marked locations from the existing STEM lamella were extracted and welded to specific grids suitable for both APT and STEM. The samples were then re-imaged and marked again in STEM. Using the STEM marks to guide further FIB machining, the pillars were further processed into needle-shaped samples suitable for APT, centered at the precise locations of the threading defects. Composition and elemental distribution, in and around dislocations, were studied using atom probe tomography (APT). In the presentation, we will compare dopant distribution in dislocation-free regions and at dislocation cores.
APT analysis confirmed approximately 100 ppm Mg dopant in the p-type GaN region. The results clearly indicate Mg diffusion along the dislocation core through the electron blocking layer, resulting in a line concentration of 79 dopant atom per 100 nm inside the substrate. The study demonstrates the unique capability of site-specific analysis of defects in device structures using correlative STEM and APT analysis, providing detailed insight into the diffusion behavior of dopant in and around threading defects.
[1] Oka, T. Ina, Y. Ueno, J. Nishii, Appl. Phys. Express 2015, 8, 6.
[2] Sakurai, et. al., Appl. Phys. Express 2020, 13, 086501.
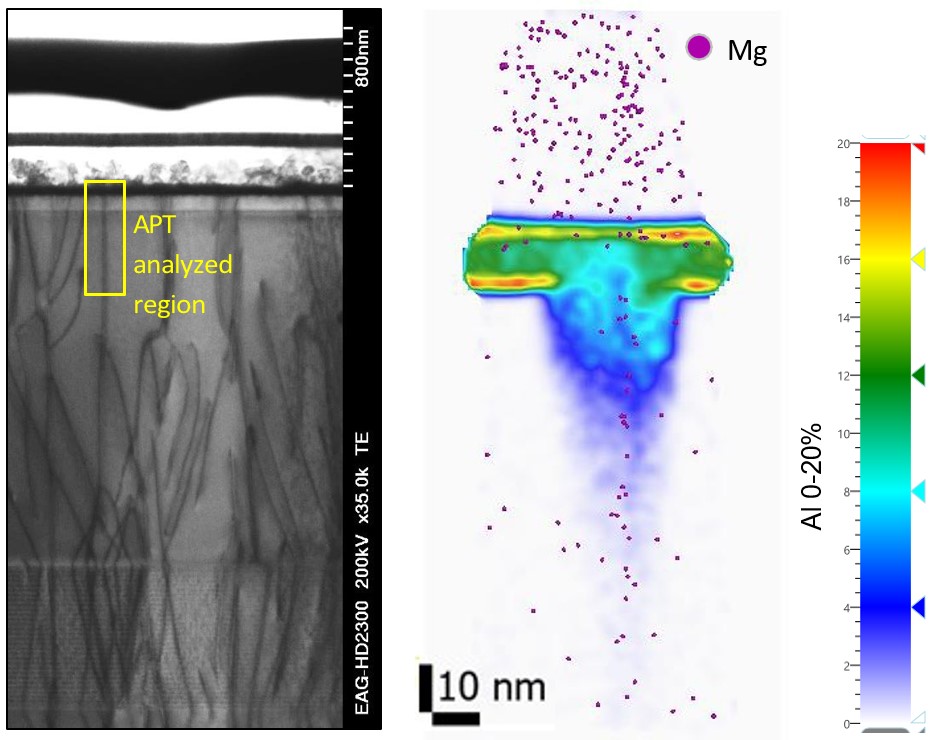

In this webinar we introduce Extractable and Leachable tests which identify chemical components that can migrate out of a product.

Medical device regulations are not entirely clear, EAG shows the decision process for contract analytical laboratories to support development.
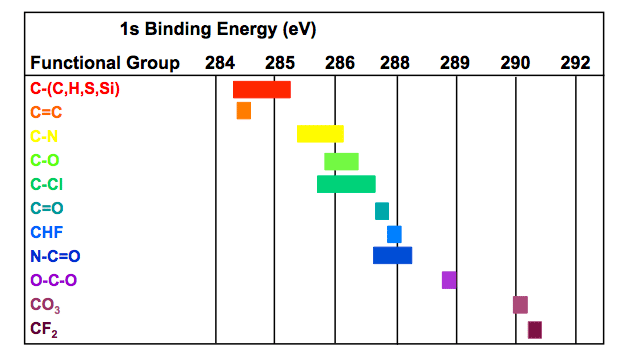
XPS shows the species present can be determined or estimated from the measured chemical shift of the binding energy of each element
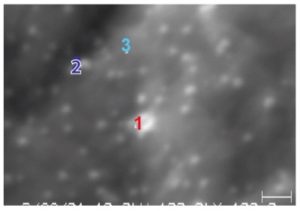
Auger Electron Spectroscopy (AES) is effective in determining the quality of passivation layers to prevent corrosion in medical devices.

This webinar will focus on Electron Backscatter Diffraction (EBSD) and Electron channeling contrast imaging (ECCI)

SIMS analytical technique typical detection limits for impurities in a HgCdTe matrix for normal depth profiling conditions.
To enable certain features and improve your experience with us, this site stores cookies on your computer. Please click Continue to provide your authorization and permanently remove this message.
To find out more, please see our privacy policy.